Les céramiques de nitrure de silicium (Si₃N₄), en tant que céramiques structurelles avancées, possèdent d'excellentes propriétés telles qu'une résistance à haute température, une résistance élevée, une ténacité élevée, une dureté élevée, une résistance au fluage, une résistance à l'oxydation et une résistance à l'usure. De plus, ils offrent une bonne résistance aux chocs thermiques, des propriétés diélectriques, une conductivité thermique élevée et d'excellentes performances de transmission des ondes électromagnétiques haute fréquence. Ces propriétés globales exceptionnelles les rendent largement utilisés dans les composants structurels complexes, en particulier dans l'aérospatiale et d'autres domaines de haute technologie.
Cependant, Si₃N₄, étant un composé avec de fortes liaisons covalentes, possède une structure stable qui rend difficile le frittage à haute densité par diffusion à l'état solide uniquement. Pour favoriser le frittage, des auxiliaires de frittage, tels que des oxydes métalliques (MgO, CaO, Al₂O₃) et des oxydes de terres rares (Yb₂O₃, Y₂O₃, Lu₂O₃, CeO₂), sont ajoutés pour faciliter la densification via un mécanisme de frittage en phase liquide.
Actuellement, la technologie mondiale des dispositifs à semi-conducteurs évolue vers des tensions plus élevées, des courants plus importants et des densités de puissance plus élevées. La recherche sur les méthodes de fabrication de céramiques Si₃N₄ est approfondie. Cet article présente les processus de frittage qui améliorent efficacement la densité et les propriétés mécaniques complètes des céramiques de nitrure de silicium.
Méthodes de frittage courantes pour les céramiques Si₃N₄
Comparaison des performances des céramiques Si₃N₄ préparées par différentes méthodes de frittage
1. Frittage réactif (RS) :Le frittage réactif a été la première méthode utilisée pour préparer industriellement des céramiques Si₃N₄. C’est simple, économique et capable de former des formes complexes. Cependant, son cycle de production est long, ce qui n’est pas propice à une production à l’échelle industrielle.
2. Frittage sans pression (PLS) :Il s’agit du processus de frittage le plus basique et le plus simple. Cependant, cela nécessite des matières premières Si₃N₄ de haute qualité et aboutit souvent à des céramiques avec une densité plus faible, un retrait important et une tendance à se fissurer ou à se déformer.
3. Frittage à chaud (HP) :L'application d'une pression mécanique uniaxiale augmente la force motrice du frittage, permettant ainsi de produire des céramiques denses à des températures de 100 à 200 °C inférieures à celles utilisées dans le frittage sans pression. Ce procédé est généralement utilisé pour fabriquer des céramiques en forme de bloc relativement simples, mais il est difficile de répondre aux exigences d'épaisseur et de forme des matériaux de substrat.
4. Frittage par plasma étincelant (SPS) :Le SPS se caractérise par un frittage rapide, un affinement des grains et des températures de frittage réduites. Cependant, le SPS nécessite des investissements importants en équipement, et la préparation de céramiques Si₃N₄ à haute conductivité thermique via SPS est encore au stade expérimental et n'a pas encore été industrialisée.
5. Frittage sous pression de gaz (GPS) :En appliquant une pression de gaz, cette méthode inhibe la décomposition de la céramique et la perte de poids à haute température. Il est plus facile de produire des céramiques haute densité et permet une production par lots. Cependant, un processus de frittage sous pression de gaz en une seule étape a du mal à produire des composants structurels avec une couleur et une structure internes et externes uniformes. L’utilisation d’un processus de frittage en deux ou plusieurs étapes peut réduire considérablement la teneur en oxygène intergranulaire, améliorer la conductivité thermique et améliorer les propriétés globales.
Cependant, la température de frittage élevée du frittage sous pression de gaz en deux étapes a conduit les recherches antérieures à se concentrer principalement sur la préparation de substrats céramiques Si₃N₄ présentant une conductivité thermique élevée et une résistance à la flexion à température ambiante. La recherche sur les céramiques Si₃N₄ possédant des propriétés mécaniques complètes et des propriétés mécaniques à haute température est relativement limitée.
Méthode de frittage en deux étapes sous pression de gaz pour Si₃N₄
Yang Zhou et ses collègues de l'Université de technologie de Chongqing ont utilisé un système d'aide au frittage composé de 5 % en poids d'Yb₂O₃ + 5 % en poids d'Al₂O₃ pour préparer des céramiques Si₃N₄ en utilisant des processus de frittage sous pression de gaz en une et deux étapes à 1 800 °C. Les céramiques Si₃N₄ produites par le processus de frittage en deux étapes présentaient une densité plus élevée et de meilleures propriétés mécaniques complètes. Ce qui suit résume les effets des processus de frittage sous pression de gaz en une et deux étapes sur la microstructure et les propriétés mécaniques des composants céramiques Si₃N₄.
Densité Le processus de densification de Si₃N₄ implique généralement trois étapes, avec un chevauchement entre les étapes. La première étape, le réarrangement des particules, et la deuxième étape, la dissolution-précipitation, sont les étapes les plus critiques pour la densification. Un temps de réaction suffisant à ces étapes améliore considérablement la densité de l’échantillon. Lorsque la température de pré-frittage pour le processus de frittage en deux étapes est réglée à 1 600 °C, les grains de β-Si₃N₄ forment une charpente et créent des pores fermés. Après le pré-frittage, un chauffage supplémentaire à haute température et sous pression d'azote favorise l'écoulement et le remplissage de la phase liquide, ce qui contribue à éliminer les pores fermés, améliorant ainsi la densité des céramiques Si₃N₄. Par conséquent, les échantillons produits par le processus de frittage en deux étapes présentent une densité et une densité relative plus élevées que ceux produits par le frittage en une seule étape.
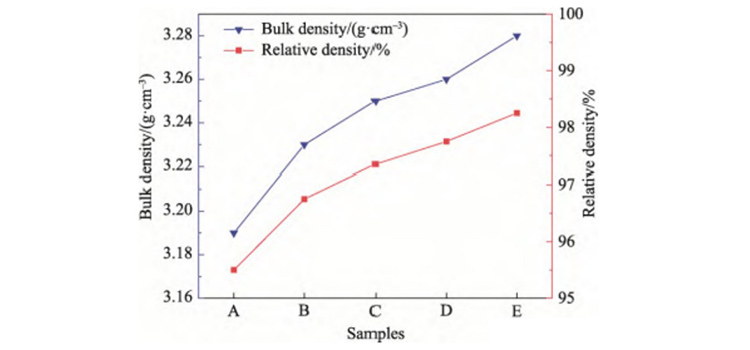
Phase et microstructure Lors du frittage en une seule étape, le temps disponible pour le réarrangement des particules et la diffusion aux limites des grains est limité. Dans le processus de frittage en deux étapes, la première étape est réalisée à basse température et à faible pression de gaz, ce qui prolonge le temps de réarrangement des particules et donne des grains plus gros. La température est ensuite augmentée jusqu'au stade à haute température, où les grains continuent de croître tout au long du processus de maturation d'Ostwald, produisant des céramiques Si₃N₄ haute densité.
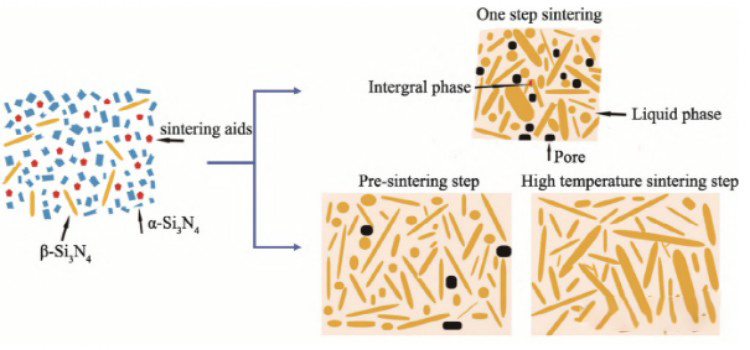
Propriétés mécaniques Le ramollissement de la phase intergranulaire à haute température est la principale raison de la résistance réduite. Lors du frittage en une seule étape, une croissance anormale des grains crée de petits pores entre les grains, ce qui empêche une amélioration significative de la résistance à haute température. Cependant, dans le processus de frittage en deux étapes, la phase vitreuse, uniformément répartie dans les joints de grains, et les grains de taille uniforme améliorent la résistance intergranulaire, ce qui se traduit par une résistance à la flexion à haute température plus élevée.
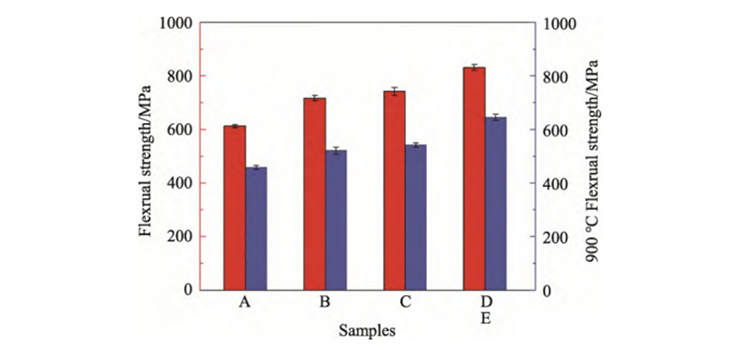
En conclusion, un maintien prolongé pendant le frittage en une seule étape peut réduire efficacement la porosité interne et obtenir une couleur et une structure internes uniformes, mais peut conduire à une croissance anormale des grains, ce qui dégrade certaines propriétés mécaniques. En employant un processus de frittage en deux étapes – utilisant un pré-frittage à basse température pour prolonger le temps de réarrangement des particules et un maintien à haute température pour favoriser une croissance uniforme des grains – une céramique Si₃N₄ avec une densité relative de 98,25 %, une microstructure uniforme et d'excellentes propriétés mécaniques complètes. peut être préparé avec succès.
| Nom | Substrat | Composition de la couche épitaxiale | Processus d'épitaxie | Milieu épitaxial |
| Homoépitaxiale de silicium | Si | Si | Épitaxie en phase vapeur (VPE) | SiCl4+H2 |
| Silicium hétéroépitaxial | Saphir ou spinelle | Si | Épitaxie en phase vapeur (VPE) | SiH₄+H₂ |
| GaAs homoépitaxial | GaAs | GaAs GaAs | Épitaxie en phase vapeur (VPE) | AsCl₃+Ga+H₂ (Ar) |
| GaAs | GaAs GaAs | Épitaxie par faisceau moléculaire (MBE) | Ga+As | |
| GaAs hétéroépitaxial | GaAs GaAs | GaAlAs/GaAs/GaAlAs | Epitaxie en phase liquide (LPE) Phase vapeur (VPE) | Ga+Al+CaAs+H2 Ga + Cendres3+PH3+CHl+H2 |
| GaP homoépitaxial | Écart | GaP(GaP;N) | Epitaxie en phase liquide (LPE) Epitaxie en phase liquide (LPE) | Ga+GaP+H2+(NH3) Ga+GaAs+GaP+NH3 |
| Super-réseau | GaAs | GaAlAs/GaAs (faire du vélo) | Épitaxie par faisceau moléculaire (MBE) MOCVD | Ca, Comme, Al GaR₃+AlR3+AsH3+H2 |
| InP homoépitaxial | InP | InP | Épitaxie en phase vapeur (VPE) Epitaxie en phase liquide (LPE) | PCl3+In+H2 In+InAs+GaAs+InP+H₂ |
| Epitaxie Si/GaAs | Si | GaAs | Épitaxie par faisceau moléculaire (MBE) MOGVD | Ga、As GaR₃+AsH₃+H₂ |
Heure de publication : 24 décembre 2024
